1 引言
射频技术是无线通信发展的关键技术之一。由于在射频系统中大量地使用无源元件,在元器件和互连中存在较强的寄生效应,射频系统封装的设计优化对提高整个系统的性能显得非常重要,高性能射频电路的设计、制造和封装已经是目前研究的热点。
采用微细加工工艺将微米尺度下的微机械部件和 IC电路制作在同一个芯片上形成高度集成的功能单元。由于MEMS单元具有体积小、响应快、功耗低、成本低的优点,具有极为广阔的应用前景[1] 。
在目前的通信系统中使用大量射频片外分立单元,如谐振器、滤波器、耦合器等,使系统的空间尺寸较大。利用MEMS技术可以同标准集成电路工艺兼容,制作的无源元件有利于系统集成度和电学性能的提高,并且成本更低。但随之而来的是对这类RF-MEMS系统元件和封装问题的研究,这些也成为人们关注的热点。
2 RF-MEMS系统级封装的优势
系统级封装(System in a Package,即SiP)由于减少了连线距离,减小了寄生效应,提高了系统的电性能和集成度,同时由于可直接采用现有IC工艺制造元件,而不像SoC那样需要完全重新设计所有元件,使得SiP应用的范围非常广泛,成本也比较低,具有非常好的发展前景。
RF-MEMS系统的封装设计必须既考虑到封装体对RF器件的影响,又要考虑封装MEMS元件的一些特殊性,如在射频条件下由封装引入的寄生电感、寄生电容会引起信号串扰、延迟等等。特别是在输入和输出端口位置,这些连接和界面的电学性能将直接影响系统的电学性能[2]。若采用系统级封装,可使信号在封装体内直接传输,这样可缩短系统内元件间的连线距离,降低系统的寄生效应,改善了互连的电学性能。在RF系统中无源器件数量多,面积大,它们的集成对系统性能的影响较大。而利用MEMS工艺加工的无源元件的可集成性正是MEMS的突出优点之一,也有利于系统级封装的实现。因此,将RF-MEMS元件进行系统级封装对于简化系统结构、降低寄生效应和损耗、提高应用频率范围、缩短产品开发时间、降低成本都具有重要意义。
图1为ANADIGICS公司关于RF系统封装的示意图,其中集成了表面安装器件(SMD)、集成式无源元件(硅或玻璃基板)、存储器芯片,使用倒装焊连接到系统中,同时还可将不同衬底材料制作的RF-CMOS芯片、GaAs高性能功率放大器隐埋在基板中,在基板上利用HDI技术制作掩埋式无源元件、传输线等,最后再次使用倒装焊实现系统与电路板的互连,这种系统级封装可明显缩短互连,提高集成度和系统性能[3]。
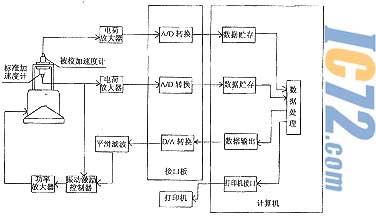
系统级封装的另一个重要优点是从系统设计阶段开始就必须考虑其封装问题,即系统与封装进行协同设计,这样可以最大地降低其封装成本、提高产品的性能和缩短产品的开发周期。
3 RF-MEMS系统级封装的关键技术
在RF-MEMS系统封装中,有如下几个关键问题需要重点考虑:无源元件的集成方式、封装结构的设计、系统内芯片间的互连以及封装材料的选择等。
3.1 无源元件集成
无源元件在RF系统中数目众多,占用系统面积大。有统计表明,无源元件(电容、电感、电阻等)在RF系统中占到元件数目的80%到90%,占基板面积的70%到80%[3],因此,无源元件的集成对于提高系统的集成度非常重要。同目前常用的表面安装无源元件相比,将元件集成于封装内可以有效地提高系统的可靠性、缩短导电通路、降低寄生效应、降低成本、减小器件尺寸。
通常RF-MEMS无源元件有一些可动部分或悬空结构,如可变电容、开关等,图2(a)所示为清华大学微电子所用MEMS工艺制作的压控电容的结构图[4]。此外,有些元件具有硅杯空腔或立体结构,图2(b)所示为三维电感[5]。这些可动和立体MEMS元件的封装与传统的集成电路塑料封装不同,它们需要足够大的超净空腔以容纳立体结构,或给悬空可动部件以足够的运动空间,并实行真空封装以降低阻尼和防止微粒进入活动部件孔隙,延长可动部分的寿命。
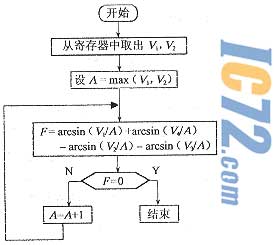
无源元件的集成方式主要有分离式、集成式和掩埋式三种。分离式是将封装好的元件安装到系统中,集成度最低,但目前的工艺比较成熟;集成式是将制作好的未经封装的无源元件或者无源元件阵列用一定的互连方式集成到系统中;而掩埋式则是直接在基板上制作无源元件,在基板内部进行连接,实现了最短的互连和最高的封装效率。集成式和掩埋式的无源元件集成技术对进一步实现系统级封装很有意义。
3.2 RF-MEMS的封装结构
除要考虑无源元件的立体结构外,RF-MEMS 元件封装另一个重要问题是封装工艺的设计,由于MEMS元件的特殊结构,在封装时会遇到一些特殊的问题:如何将加工好的非平面易损坏的MEMS元件放置在封装系统的相应位置,封装过程中引入的热应力、机械应力、振动等均有可能破坏这些元件。因此需要针对不同的封装结构和元件设计合理的封装流程,选用合理的封装材料对保证系统性能、提高可靠性都很有意义。如拥有可动结构的 MEMS元件不能使用挥发有害物质的粘接剂,以避免挥发物对腔室的污染。有时封装工艺与器件制作工艺可能交叉进行,比如先完成管芯的粘接再释放牺牲层等,这些都不同于传统的集成电路封装,需要重新考虑流程。
另外,RF-MEMS元件往往具有不规则的芯片外形,以及多个元件的集成。在射频下,信号的传输匹配显得更加重要,对能否发挥出系统级封装的优势也很关键。因此,RF-MEMS元件往往没有现成的封装可以利用,并且需要利用ANSYS、 MEMCAD、HFSS等高频和封装模拟软件来进行辅助设计,优化系统结构,缩短设计周期。
3.3 互连技术
目前常见的一级互连技术有如下几种:引线键合、倒装焊、载带自动焊(TAB),另外,还有高密度互连(HDI)技术,是将再布线同封装结合在一起。封装内互连的电学性能对系统的性能影响很大,同时互连方式的选择对封装工艺流程也会有相应影响,需要同时考虑。
引线键合由于其发展较早,工艺成熟度高,工艺过程简单,目前在RF产品中仍占主导地位,但引线丝较大的电感将限制其在更高频段下的应用。倒装焊技术无疑将成为这一领域的发展趋势,它有如下几个优点:较短的导电路径,更小的寄生效应,更小的电阻,焊球阵列焊接时的自对准特性使得封装成品率较高,倒装焊技术与表面安装技术是兼容的。
在射频领域,系统性能对互连的寄生效应很敏感,如果互连上存在较大的寄生电容和电感,那样将产生较大的损耗。IMEC对比了引线键合和倒装焊两种键合方式[5],在4.7GHz下,倒装焊引入的电感量为几十pH,而引线键合引入的电感量通常都在nH量级。根据JEDEC的JESD59标准中规定的键合引线模型标准[6]建模,利用引线电感近似公式[7],常用金丝引线的直径为25.4μm,长度在1.02~2.03mm之间,计算所得其自感值在0.73~1.73nH之间,符合IMEC的结果。在低频下两种互连的电学性能相差不多,但应用在射频范围内时,则两者将出现数量级的差异。利用近似计算或电磁场模拟很容易发现,如果管芯引出端数较高时,引线带来的互感更高,单个凸点电学性能好、距离大的面阵列凸点倒装焊技术的优势更明显。但MEMS芯片的特殊结构可能对凸点的制作带来一定困难,需要针对整个系统综合考虑。
3.4 封装基板材料的选择
在射频条件下,电磁波不但在导线中传播而且同时也在周围的电介质中传播,会对信号造成一定的损耗和干扰。因此封装材料的介电性能将会影响系统的高频性能。比如系统中应用的基板材料、互连材料以及封盖材料等的选择,都是RF封装中需考虑的重要因素。
在封装系统中基板对管芯提供机械支撑和电信号通路,同时为管芯和基板的I/O的连接提供再分布;另外,还可将无源元件嵌入基板中,提高系统的集成程度。通常在高频下采用损耗较低的低温共烧陶瓷(LTCC)作为封装基板;Dupont公司曾对比了普通高分子(FR-4)和低温共烧陶瓷基板的损耗,结果如图3所示[8]:

另外,在封装中互连材料的选用,比如不同种类凸点造成电阻值、寄生电感、寄生电容以及互感的差异。在一些封装中(如FC),使用下填料、包封塑料等,都会导致一定的漏电和串扰。
最近的研究主要集中在高性能高分子材料上,特别是在介电常数、损耗、CTE等性能的改进方面[9] ,从降低成本的角度考虑,高性能的高分子材料很可能会成为RF封装的主流。
4 结论
综上所述,对于MEMS工艺加工的射频系统来说,系统级封装是一种很好的选择,提高了系统的集成度,缩小了封装尺寸,缩短了元件间的互联距离和界面的数量,减小了损耗,降低了封装成本。除了需要考虑射频系统封装的一些常见问题外, RF-MEMS系统级封装还需要根据不同的系统或子系统的组成和要求,在封装结构的设计、无源元件的集成方式、互联形式和封装材料的选取上考虑RF-MEMS元器件的特性进行设计、比较和折衷。在对封装进行设计的同时,也需要同时考虑到封装的流程,以达到最优的性能。
|